
微細化が進む現代の半導体製造では、回路の多層化が一般的であり、各層の形成後に表面を平坦にすることが求められます。この平坦化プロセスにより、次の層のリソグラフィ工程で高精度なパターン転写が可能となりました。
こちらでは、半導体ウェーハの表面を平坦化するCMP装置について解説します。
CMP装置とは、Chemical Mechanical Polishing(化学機械研磨)の略で、半導体ウェーハの表面を平坦化する装置です。スラリーと呼ばれる研磨剤を用いて化学反応を起こしながら、機械的に研磨します。配線の短絡や断線を防ぎ、信号伝達の精度を高めることが可能です。
CMPは、微細な電子スイッチや配線を正確に形成するために不可欠な工程になります。
CMP装置は主に、プラナリゼーション(平坦化)という作業を行います。プラナリゼーションとは、半導体ウェーハ表面の凹凸を均一に整えること。この過程では、ポリッシュという研磨技術が用いられます。
多層構造を持つ半導体デバイスにおいて、プラナリゼーションは、各層の正確な形成を可能にするために重要な工程です。
一方、ポリッシュは、ウェーハ表面を鏡面のように滑らかにすることを目的とします。プラナリゼーションが構造の均一性を確保するプロセスであるのに対し、ポリッシュは表面をなめらかにすることでプラナリゼーションを実現し、その結果として光学的特性や電気的特性の向上につながります。
CMP装置は、スラリーと呼ばれる研磨剤を用いて化学反応を起こしながら、機械的に研磨します。これにより、配線の短絡や断線を防ぎ、信号伝達の精度を高めることが可能です。
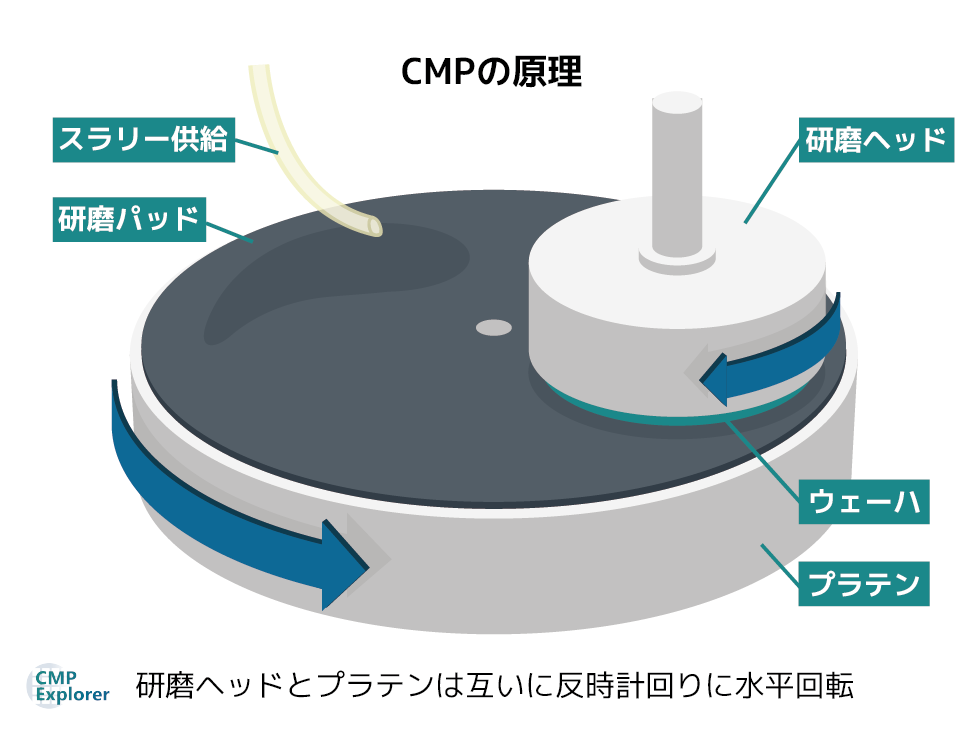
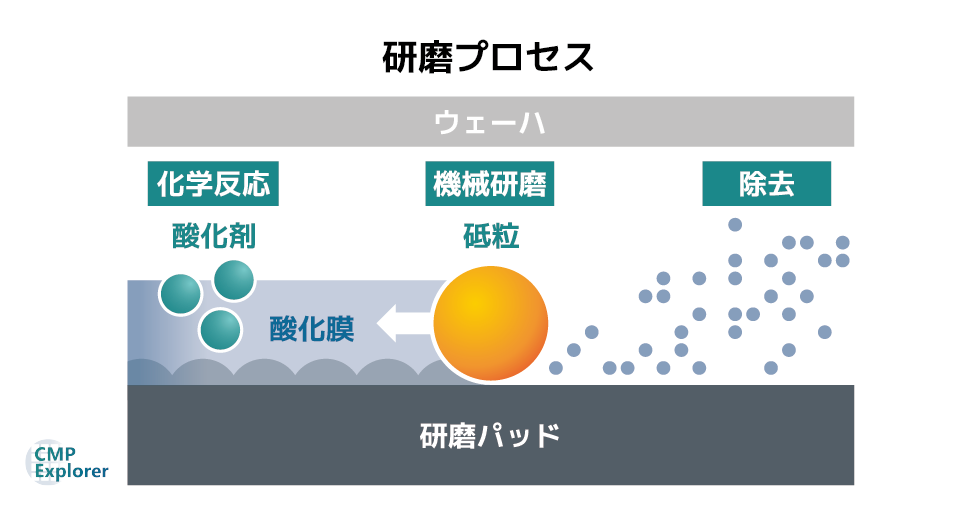
CMP装置の原理は、化学反応と機械的研磨の組み合わせに基づいています。研磨パッド上にウェーハを置いて、スラリーを供給しながらウェーハを回転。この際、パッドとウェーハの間に圧力を加えることで、ウェーハ表面の不要な物質を除去することが可能です。
CMP装置は、高精度な平坦化を実現するために複数の構成要素が連携して動作します。各要素が持つ役割と機能を理解することは、装置選定や運用の最適化に重要です。こちらでは、CMP装置を構成する主要な要素について詳しく解説します。
研磨パッドは、ウェーハ表面と直接接触して研磨を行う消耗部材です。ポリウレタン製のパッドが一般的で、熱可塑性と熱硬化性の2種類があります。パッド表面には微細な気孔があり、この構造がスラリーの保持と均一な研磨を可能にします。
パッドの硬度や表面構造は研磨性能に大きく影響し、グローバル平坦化プロセスでは軟らかいパッド、分離プロセスでは硬いパッドが選ばれます。また、パッド表面には格子状や同心円状の溝が加工されており、スラリーの均一供給とウェーハの水平移動を助ける役割を果たします。交換時期の判断は研磨レートの変化やパッド表面の摩耗状態で行います。
研磨定盤は、研磨パッドを支える回転基盤であり、装置の安定性と研磨精度を左右する重要な構成要素です。定盤は高い機械剛性を持ち、回転時の振動を最小限に抑える設計になっています。
定盤の回転速度と圧力制御により、研磨レートと均一性を調整できます。量産用の大型装置では、300mmや450mmウェーハに対応した大型定盤が搭載され、温度管理機能も備えています。定盤の平坦度は研磨品質に直結するため、定期的なメンテナンスと平坦度測定が欠かせません。
キャリアヘッドは、ウェーハを保持しながら研磨パッドに押し付ける装置です。ウェーハ全面に均一な圧力を加えることで、平坦な研磨面を実現します。
先進的なキャリアヘッドには、ゾーンコントロール機能が搭載されており、ウェーハの中心部と外周部で圧力を個別に調整できます。リテーナーリングと呼ばれる部品がウェーハ外周を保護し、エッジの過剰研磨(ふちだれ)を防ぎます。量産機では自動着脱機能により、スループット向上を実現しています。
スラリー供給システムは、研磨に必要なスラリーを適切な流量と濃度で供給する装置です。スラリーには研磨粒子の凝集を抑えるため、ポンプレスの真空吸引・窒素ガス圧送方式が採用されることもあります。
システムには流量制御、温度管理、フィルタリング機能が備わっており、安定した研磨性能を維持します。量産ラインでは複数のCMP装置に集中供給する方式が採用され、スラリーの均質化と高精度な調合が自動化されています。過酸化水素水などの添加剤濃度も自動測定・補充されます。
コンディショナーは、研磨パッド表面の目立て直しを行う工具です。研磨中にパッド表面の微細孔が目詰まりすると、研磨レートが低下し平坦性が劣化するため、定期的なコンディショニングが必要になります。
一般的にはダイヤモンド粒子を電着した円盤状のコンディショナーが使用され、パッド表面を削り取って研磨性能を回復させます。コンディショニングの頻度はパッドの種類や研磨条件によって異なりますが、適切な実施がパッド寿命の延長につながります。近年では、超音波や超高圧純水による非接触型のコンディショニング技術も開発されています。
洗浄システムは、CMP後のウェーハから研磨材のカス、薬品の残留物、削られた屑などを除去する装置です。研磨後の洗浄が不十分だとパーティクル欠陥の原因となります。
洗浄には、ブラシ洗浄とメガソニック洗浄の組み合わせが用いられます。ブラシ洗浄ではPVA(ポリビニルアルコール)製のブラシでウェーハ表面をこすり、メガソニック洗浄では超音波の振動で微細な汚染物質を除去します。薬液スプレーによる化学洗浄も併用され、最後に乾燥工程で水分を完全に除去します。クリーンな状態で次工程に送ることが、歩留まり向上の鍵となります。
エンドポイント検出装置は、研磨の終了時点を判断する計測システムです。削りすぎを防止し、目標の膜厚に仕上げるために不可欠な機能です。
検出方式には、トルク検出法、光学式膜厚測定、静電容量法、振動解析法などがあります。トルク検出法では、研磨中のキャリアヘッドや定盤のトルク電流変化から、材料の切り替わりを検出します。光学式ではレーザー光の反射を利用して膜厚を測定し、複数の方式を組み合わせることで検出精度を高めています。量産装置では、エンドポイント検出の精度が歩留まりに直結するため、開発競争が激しい分野です。
制御システムは、CMP装置全体を統合管理するコンピュータシステムです。各構成要素の動作を協調制御し、安定した研磨プロセスを実現します。
レシピ管理機能により、製品ごとの最適な研磨条件(圧力、回転速度、スラリー流量、研磨時間など)を保存・呼び出しできます。データロギング機能では、研磨履歴をすべて記録し、トレーサビリティを確保します。量産機では、ホストコンピュータとの通信機能やAGV(カセット自動搬送車)対応により、完全自動化された生産ラインを構築できます。卓上型装置でも基本的な制御機能は備えていますが、自動化レベルは量産機より簡素化されています。
スラリーには、ウェーハ表面の特定の物質を溶解させる化学成分が含まれています。
例えば、銅配線の場合、スラリーに含まれる酸化剤が銅を酸化し、研磨が容易になるというわけです。この化学作用により、不要な物質が効率的に除去されます。
化学薬品による処理で柔らかくなった物質を、パッドによる機械的な摩擦で除去します。研磨パッドには微細な凹凸があり、この凹凸で物質を削り取ります。
化学と機械のバランスを保つことで、ナノメートル単位の平坦化が実現されるのです。
CMP装置の価格は、用途や仕様によって大きく異なります。量産用の据え置き型CMP装置は、数千万円から数億円の範囲で取引されるのが一般的です。
研究開発や試作目的の卓上型CMP装置は、数百万円で提供されている製品もあれば、数千万円を超える製品も少なくありません。
EVや再エネ分野での採用が急拡大するSiCパワーデバイス。その性能と歩留まりを決定づけるのが、ウェハ表面を原子レベルで平坦化する「研磨技術」です。しかし、SiC特有の物性により、シリコンと同様の研磨方法では通用しないのが現実です。
本記事では、SiC CMPの基礎メカニズムをはじめ、高品質なエピレディ表面を実現する二段研磨プロセスや、コストダウンの鍵となる次世代のプラズマ研磨技術について、実務的な視点で紐解きます。
スマートフォンや高性能プロセッサの進化により、SOIウェーハの需要が急拡大しています。その製造において、ナノレベルの平坦性を実現するCMP(化学機械研磨)は、デバイス性能を決定づける重要工程です。しかし、特殊な積層構造を持つため、従来の技術だけでは対応できません。
本記事では、膜厚制御やBOX層の保護など、高度な精度が求められるSOI向けCMPならではの技術的特徴と課題について解説します。
高い処理能力と耐久性を持ち、大量のウェーハを短期間で処理することが目的です。そのため、エンドポイント検出機能やスラリー供給システムの自動監視といった、自動プロセス制御機能や複雑な設定が求められます。
研究開発や試作段階での使用を目的としており、コンパクトな設計です。
処理能力や耐久性よりも柔軟性が重視され、大量生産向けの高精度な制御システムや大型の機構が不要なため、据え置き型より価格も低めです。
このメディアでは、CMP装置の導入を検討している企業向けにさまざまなCMP装置メーカーを紹介しています。

柔軟性と高い機械剛性を備え、角チップも取り付け可能。金属・酸化・窒化膜、ベアウエハはもちろん材料や関連商品などの研究開発向けに、試作の細かな調整がスムーズに行える卓上型CMP装置。
| ウェーハ サイズ |
チップサイズ ~150mm |
|---|

自動研磨機能と4つのテーブルを使ったデュアルモジュール構造で効率的な半導体製造の歩留まり向上を実現。安定した品質と高い生産効率を提供。
| ウェーハ サイズ |
~300mm |
|---|

大型基板の高密度配線やTSV(貫通電極)プロセスの複雑な構造に対応した450mmウェーハ用では世界初※の全自動CMP装置。ポリッシュ取り代量の多い工程でも、安定した研磨性能。
| ウェーハ サイズ |
~450mm |
|---|
CMP(化学機械研磨)装置市場は、数社の大手メーカーが高いシェアを占めており、競争が激化しています。各社は装置の性能、スラリー供給、サポート体制などで差別化を図り、市場シェアの拡大を狙っています。
CMP装置市場は、米国と日本の企業が大きなシェアを持つ構造となっています。
市場シェアは企業の技術力や顧客基盤によって変動しますが、特に大手企業は世界中の半導体メーカーとの取引関係を持ち、一定のシェアを維持。一方、ニッチ市場を狙う企業も一定のシェアを確保し、市場には多様な製品が供給されているのが特徴です。
CMP装置市場の動向を理解することで、装置選定やメーカー比較の参考となる情報を得ることができます。CMP装置の選択はプロセスの効率性や製品の品質に直結するため、慎重に行うことが求められます。
参照元:[PDF]経済産業省-半導体・デジタル産業戦略(https://www.meti.go.jp/press/2023/06/20230606003/20230606003-1.pdf)2022年時点
半導体製造でウェーハ平坦化を担うCMP装置は、性能低下が歩留まりに直結するためメンテナンスが必須です。日常点検から週次・月次・年次PM、大規模オーバーホールまで段階的に実施し、スラリー管理、センサーログ活用で異常がないかチェックします。
そんなメンテナンスについての流れや装置種類別のメンテナンス手順について解説します。
CMP装置の選定は、対象工程とゴール(品質・生産性・運用)を先に定義すると失敗しにくくなります。
CMPは消耗品と日常管理の比重が高い工程です。パッドの状態、スラリーの管理、洗浄の徹底が欠陥やばらつきに直結します。運用を含めた設計・体制まで比較することが重要です。
CMP装置の寿命は、使用環境やメンテナンス頻度によって異なりますが、一般的に量産向けの据え置き型装置であれば10年以上、場合によっては15年以上の稼働も可能です。重要なのは、定期的な部品交換や清掃、パッド・スラリー系統の適切な管理です。特に定盤モーターやスラリー供給ラインは経年劣化が起こりやすく、放置すると精度低下や振動の原因となります。
メーカー推奨の保守スケジュールに沿って日次・週次・年次点検を行うことで、安定稼働期間を長く維持できます。また、センサーや制御系のキャリブレーションを定期的に実施することで、研磨品質の再現性を確保し、歩留まりを安定させることが可能です。
研磨パッドは、研磨レート(除去速度)の低下や表面の摩耗、目詰まりが見られるタイミングで交換が必要です。パッド表面の状態は平坦化性能に直結するため、定期的なドレッシング(目立て直し)と点検が欠かせません。一般的に数十〜数百枚のウェーハ研磨ごとに再生し、数千枚単位で交換するのが目安です。
スラリーは化学的安定性が保たれる期間(通常1〜2週間程度)を過ぎると粒子の凝集やpH変化が発生し、研磨ムラの原因になります。沈殿や変色が見られたらすぐに交換しましょう。近年はAIによるスラリー劣化検知システムも普及し、交換タイミングの最適化が進んでいます。
装置選定のポイントは「目的」と「ウェーハサイズ」です。研究・試作や大学・企業のR&D用途では、設置スペースを取らず、条件変更が容易な卓上型CMP装置が適しています。小型でも圧力・回転制御が可能で、少量生産や新素材開発に向いています。
一方、量産ラインではスループットと再現性が求められるため、自動制御やスラリー循環システムを備えた据え置き型が主流です。特に300mmウェーハ以上を扱う場合は、大型定盤と高精度エンドポイント検出機能が必須です。必要な平坦度や運用コストも踏まえて選定するのが理想です。
CMP工程で発生する不良には、過研磨、膜厚ムラ、スクラッチ(傷)、パーティクル残留などがあります。これらの多くはスラリーの不均一供給、パッド摩耗、圧力制御の誤差などが原因です。スラリー流量が不安定だと化学反応が偏り、平坦度にムラが生じやすくなります。
また、洗浄工程での不十分な除去は次工程での歩留まり低下につながります。近年はリアルタイムトルク監視やエンドポイント検出技術の進化により、これらの不良を事前に防止できるようになっています。定期的な装置校正とプロセス最適化が品質維持の鍵です。
CMP装置は初期導入費用のほかに、ランニングコストも無視できません。スラリーやパッドなどの消耗品、定期メンテナンス、薬液処理、電力コストが主な項目です。特にスラリーは使用量が多く、運用コスト全体の3〜4割を占めることもあります。
省資源型スラリー再生システムや自動濃度調整機能を導入すれば、薬液ロスを削減してコストを最適化できます。また、データ解析を活用して予防保守を行うことで、突発的な停止リスクを低減し、結果的に運用費の抑制にもつながります。導入時は装置価格だけでなく、トータルコストを考慮することが重要です。
半導体の受託加工とは、設計から製造、組立、検査までの工程を専門企業に委託することで、効率的な生産や技術力向上を図る手法です。企業のニーズに応じた柔軟な依頼が可能で、コスト削減や生産性向上のメリットがあります。一方で、品質管理や情報漏洩のリスクもあり、慎重なパートナー選びが重要です。
CMP装置の市場規模はAIやデータセンター需要の高まりを受けて年平均5~7%で拡大しています。米中技術覇権争いによるサプライチェーン再編や、日本政府の強靭化策が国内需要を押し上げる一方、台湾・韓国・中国を中心としたアジア太平洋地域が世界市場をリードしています。

柔軟性と高い機械剛性を備え、角チップも取り付け可能。金属・酸化・窒化膜、ベアウエハはもちろん材料や関連商品などの研究開発向けに、試作の細かな調整がスムーズに行える卓上型CMP装置。
| ウェーハ サイズ |
チップサイズ ~150mm |
|---|

自動研磨機能と4つのテーブルを使ったデュアルモジュール構造で効率的な半導体製造の歩留まり向上を実現。安定した品質と高い生産効率を提供。
| ウェーハ サイズ |
~300mm |
|---|

大型基板の高密度配線やTSV(貫通電極)プロセスの複雑な構造に対応した450mmウェーハ用では世界初※の全自動CMP装置。ポリッシュ取り代量の多い工程でも、安定した研磨性能。
| ウェーハ サイズ |
~450mm |
|---|