CMP(化学機械研磨)は、半導体製造でウェーハ表面を均一にならす技術です。化学薬品で表面を柔らかくし、砥粒で削ることで、ナノメートル単位の平坦化を実現します。微細化や多層配線が進む半導体製造に欠かせません。
こちらでは、CMP装置の原理について解説します。
CMP(化学機械研磨、Chemical Mechanical Polishing)は、化学的作用と機械的作用を組み合わせて材料の表面を平坦化・平滑化する技術です。研磨剤(スラリー)に含まれる化学成分が表面を軟化・溶解させ、同時に砥粒が機械的に削り取ることで、ウェーハ表面を平坦化します。
微細な回路パターンの形成や多層配線の構築において、表面の平坦度はデバイス性能に直結するため、CMPは欠かせないプロセスです。
CMPは、主に半導体製造工程で以下の用途に使用されます。
| ウェーハの平坦化 | デバイス構築前のシリコンウェーハ表面を平滑に整えるために用いられます。 |
|---|---|
| 浅溝型素子分離(STI) | トランジスタ間の絶縁を目的とした浅い溝を形成し、その上を平坦化する工程で使用されます。 |
| タングステンプラグの埋め込み平坦化 | 配線層間の接続に使用されるタングステンプラグを形成した後、その表面を平坦化します。 |
| 銅配線の形成 | 銅ダマシンプロセスにおいて、銅配線を形成した後、不要な部分を除去し、表面を平坦化します。 |
これらの工程において、CMPは高精度な平坦化を実現。微細な回路パターンの形成や多層配線の構築など広く利用されています。
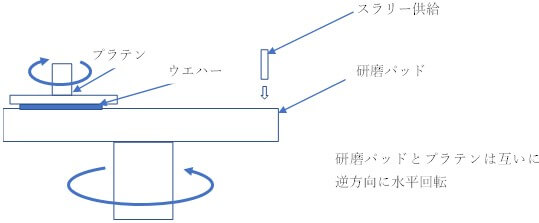
CMP装置の動作原理は、化学的作用と機械的作用の相乗効果による平坦化です。スラリー(化学薬品)がウェーハ表面を軟化させることで、砥粒による研磨が効率的に進行します。このプロセスを高精度に制御すると、ナノメートル単位の平坦度を実現できます。
CMPでは「化学反応(Chemical)」と「機械的研磨(Mechanical)」を同時に利用します。
スラリー中の化学薬品がウェーハ表面の材料(例:銅、タングステン、シリコン酸化膜、低誘電率膜など)を微量に腐食(エッチング)・酸化させます。
この化学変化で表面が軟化または脆化し、機械的研磨による除去が起こりやすくなる作用です。
スラリー中に分散した砥粒(アブレシブ)と研磨パッドによる摩擦で、ウェーハ表面を物理的に削り取ります。
ウェーハとパッドの間の圧力や相対運動により研磨速度が決まり、表面の段差や不要層を平坦化しながら除去していくのが機械的作用です。
研磨速度(削れる量)は、パッド上の圧力(P)と相対速度(V)に比例し、一般的に「Prestonの式」と呼ばれるモデルで表されます。
Removal Rate(除去率) ∝ k(定数) × P(圧力) × V(速度)
kはスラリーや材料などに依存する定数です。スラリーの種類、研磨パッドの種類、荷重(圧力)、回転数、温度などのパラメータを調整することで、表面のエッチング速度や研磨速度を最適化します。
CMP装置を使用した研磨工程は、以下の手順で実施されます。
今後、CMP技術はさらなる高精度化と低コスト化が求められ、新しい材料やスラリーの開発、装置の最適化が進むと予想されます。半導体製造技術の高度化に伴い、CMP装置の重要性はますます増していくでしょう。
このメディアでは、CMP装置の導入を検討している企業向けにさまざまなCMP装置メーカーを紹介しています。
TOPページではウェーハサイズと研磨用途別にCMP装置メーカーを比較して掲載していますので、装置選定の参考としてご活用ください。
\研究開発・安定供給・大型基板対応/
研磨用途別
CMP装置メーカー3選を見る

柔軟性と高い機械剛性を備え、角チップも取り付け可能。金属・酸化・窒化膜、ベアウエハはもちろん材料や関連商品などの研究開発向けに、試作の細かな調整がスムーズに行える卓上型CMP装置。
| ウェーハ サイズ |
チップサイズ ~150mm |
|---|

自動研磨機能と4つのテーブルを使ったデュアルモジュール構造で効率的な半導体製造の歩留まり向上を実現。安定した品質と高い生産効率を提供。
| ウェーハ サイズ |
~300mm |
|---|

大型基板の高密度配線やTSV(貫通電極)プロセスの複雑な構造に対応した450mmウェーハ用では世界初※の全自動CMP装置。ポリッシュ取り代量の多い工程でも、安定した研磨性能。
| ウェーハ サイズ |
~450mm |
|---|